世界最高クラスの高精度実装を実現



3次元積層実装や狭隣接実装、キャビティ構造基板にも対応可能な世界最高クラスの実装精度を実現。
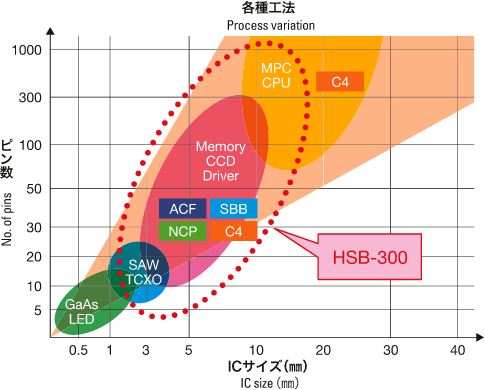
チップを高精度高速搭載します。搭載精度±2μm(3σ)以下を実現。
高精度を実現するために、カメラ内の温度変化を最小限にする制御、ステージの平行度自動調整機構、熱膨張の自動キャンセル機構等々を搭載。
| 機種名 | 高精度フリップチップボンダー | |
|---|---|---|
| 型式 | HSB-300 | |
| 対象基板サイズ | 50×50mm〜250×200mm t=0.5mm〜2.5mm | |
| 対象部品サイズ | □1mm~□15mm t=0.05mm~0.5mm(0.05mmは条件有り) | |
| 装置サイズ | (幅)1,350mm ×(奥行)1,820mm ×(高)1,550mm(*3色灯除く) | |
| 重量 | 約1,600kg | |
| 動力源 | 電源 | 3相 AC200V(50/60Hz)・単相AC100V(50/60Hz) |
| ドライエア | 0.4MPa | |
| 真空源 | -80kPa | |
| 部品供給形態 | ウエハー供給 8インチ、12インチ トレイ供給 2インチ、4インチ |
|
| 実装精度 | ±2μm/3σ(X,Y) ※弊社測定方法にて測定 | |
| 実装サイクル時間 | 1.6sec/chip ※プロセス時間は除きます | |
| 加圧レンジ | 0.5N~150N | |
| 加熱レンジ | ヘッド:常温〜Max.450℃ ステージ:常温〜Max.150℃ | |
| オプション | □300基板対応 | |
| 自動ツールチェンジ(最大4品種) | ||
| 自動ノズルチェンジ(最大4品種) | ||
| ウエハーマップ各種フォーマット対応 | ||
| チップサイズ □26mm対応 | ||
| ※お客様の仕様に合わせてカスタマイズいたします。 | ||

狭バンプピッチの接合。C4、NCP、NCF等のTCB接合工法。